底部填充技术上世纪七十年代发源于IBM公司,目前已经成为电子制造产业重要的组成部分。起初该技术的应用范围只限于陶瓷基板,直到工业界从陶瓷基板过渡到有机(叠层)基板,底部填充技术才得到大规模应用,并且将有机底部填充材料的使用作为工业标准确定下来。

图1. 毛细管底部填充从器件
边缘注入。
目前使用的底部填充系统可分为三类:毛细管底部填充、助焊(非流动)型底部填充和四角或角-点底部填充系统。每类底部填充系统都有其优势和局限,但目前使用最为广泛的是毛细管底部填充材料。
毛细管底部填充的应用范围包括板上倒装芯片(FCOB)和封装内倒装芯片(FCiP)。通过采用底部填充可以分散芯片表面承受的应力进而提高了整个产品的可靠性。在传统倒装芯片和芯片尺寸封装(CSP)中使用毛细管底部填充的工艺类似。首先将芯片粘贴到基板上已沉积焊膏的位置,之后进行再流,这样就形成了合金互连。在芯片完成倒装之后,采用分散技术将底部填充材料注入到CSP的一条或两条边(图1所示)。材料在封装下面流动并填充CSP和组装电路板之间的空隙。
尽管采用毛细管底部填充可以极大地提高可靠性,但完成这一工艺过程需要底部填充材料的注入设备、足够的厂房空间安装设备以及可以完成精确操作的工人。由于这些投资要求以及缩短生产时间的压力,后来开发出了助焊(非流动)型底部填充技术。

图2. 非流动型底部填充工艺流程
及优点。
相对于其他底部填充系统来说,非流动型底部填充的最大优点在于对工艺的改进,在材料性能方面并没有明显差异。为了让底部填充的填充过程与传统的表面组装工艺更好的兼容,非流动型底部填充不能使用控温精确度很高的固化炉。通过将助焊性能集成到底部填充材料中,CSP的粘片和材料固化工艺合二为一。在组装过程中,在元件放置之前先将非流动型底部填充材料涂覆到粘片位置上。当线路板进行再流时,底部填充材料可以作为助焊剂,协助获得合金互连,并且本身在再流炉中同步完成固化。所以可以在传统的表面组装工艺线上完成底部填充(图2)。
从设备和人员投入的角度来讲,非流动型底部填充系统节约了成本和时间,但自身也受到一些限制。与毛细管底部填充不同,非流动型底部填充材料中必须含有填充物。在底部填充材料中的填充材料可能正好位于焊料球和电路板焊盘之间。从设计上考虑,为了改善再流过程中焊料键合,要求该系统内不能含有微粒。如果没有微粒,底部填充材料的热膨胀系数(CTE)比较高,经过温度循环后其性能就不如毛细管底部填充稳定。另外,如果采用传统的再流工艺,而不进行精确温度控制也会降低再流工艺的成品率。此外电路板上吸附的湿气再流时也会被释放出来形成孔洞。但新的改进工艺已经克服了上述缺点。

图3. 预成型底部填充应用的工
艺流程。
对于带
中间插入层或边角阵列的CSP来说,采用毛细管底部填充或非流动型底部填充系统都不如角-点底部填充方法更合适。这种方法首先将底部填充材料涂覆到CSP对应的焊盘位置(图3)。与非流动型底部填充不同,角-点技术与现有的组装设备和常规的焊料再流条件兼容。由于这类底部填充是可以返修的,制造商们也避免了因为一个器件缺陷就废弃整个电路板的风险。
技术的转换需要提高可靠性
由于器件及其引脚节距变得更小、功能要求更多,并且需要产品工艺实现无铅化,因此在下一代电子产品中,底部填充技术的应用变得越来越重要。
底部填充可以提高CSP中无铅焊料连接的可靠性,与传统的锡-铅焊料相比,无铅互连更容易产生CTE失配造成的失效。由于无铅工艺的再流温度较高,封装基板的翘曲变得更为强烈,而无铅焊料本身延展性又较低,因此该种互连的失效率较高。向无铅制造转换的趋势和无铅焊料本身的脆性等综合作用,使得在器件中使用底部填充技术已经成为成本最低,选择最为灵活的解决方案。
随着产业链向引脚节距0.3mm的CSP、节距小于180祄的倒装芯片封装以及更小尺寸发展,采用底部填充材料几乎是唯一可以保证全线成品率的方法。
即将出现的可能
除了满足不断变化的机械要求,保证高可靠性之外,电子产品制造商还必须让产品的成本更具竞争力。面对这样的挑战,尚处于研发阶段的新底部填充技术,尽管仍处于一个产品的婴儿期,已经显示出很好的前景。
非流动型底部填充的优势在于工艺效率较高,并且减少了设备和人员成本。但在使用底部填充材料时遇到的技术难题使这些优势都变得不重要了。不过目前市场上出现了含有50%填充成分的非流动型底部填充材料。采用了该比例填充料之后,在保持非流动型底部填充工艺流程的同时,改善了产品的温度循环性能。
另一个备受关注的创新是预成型底部填充技术,该项技术有望在后道封装中完全消除底部填充工艺,而在CSP进行板级组装之前涂覆底部填充材料,或者在晶圆级工艺中涂覆底部填充材料。预成型底部填充在概念上很好,但要实施到当前的产品中,在工艺流程上还有一些挑战需要面对。
在晶圆级底部填充材料的涂覆中,可以在凸点工艺之前或之后涂覆预成型底部填充材料,但两种方法都需要非常精确的控制(图4)。如果在凸点工艺之前涂覆,必须考虑工艺兼容问题。与之相反,如果在凸点工艺之后涂覆,则要求预成型底部填充材料不会覆盖或者损坏已完成的凸点。此外还需考虑到晶圆分割过程中底部填充材料的完整性以及一段时间之后产品的稳定性,这些在正式使用底部填充材料到产品之前都需要加以衡量。尽管某些材料供应商对预成型底部填充材料的研发非常超前,但将这一产品投入大规模应用还有更多的工作要完成。
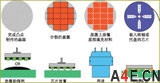
图4. 预成型底部填充应用
的工艺流程。
结论
如果没有底部填充材料的使用,当今的窄节距器件就无法克服可靠性问题。此外为了降低无铅焊料连接位置由CTE失配引起的失效率,无铅制造的工艺流程和温度要求都要求使用底部填充材料。
新工艺流程的要求、器件功能的不断增多和封装尺寸的减小,这些要素都要求越来越多地使用牢固的底部填充系统。尽管目前已有很多种不同类别的底部填充技术,为了满足电子产品多功能、低成本的要求,还需要开发出下一代低成本、工艺流程简单的底部填充技术。
-----------------------------------------------------------------------------------------------------------------------------------------
(责任编辑:admin)----[注:本网站(中国环氧树脂应用网http://www.epoxy-c.com联系人:金先生13915284081)发布的有关产品价格行情信息,仅供参考。实时价格以现实流通中为准。受众若发现信息有误,可向本网建议及时修改或删除。受众在浏览本网站某些产品信息之后,使用该产品时请向专业人士及生产商和经销商咨询,本网站不对该产品的任何使用后果负责。本站所有文章、图片、说明均由网友提供或本站原创,部分转贴自互连网,转贴内容的版权属于原作者。如果本站中有内容侵犯了您的版权,请您通知我们的管理员,管理员及时取得您的授权或马上删除!]
